Master IC Packaging
TESCANソリューションによる故障解析
プラズマ FIB-SEM のパワー
と革新的な TESCAN 大容量ワークフローを体験してください。
ニューペーパー
半導体故障解析の最適化:レーザーアブレーションとXeプラズマFIB-SEMの組み合わせの威力
プラズマFIB-SEMと組み合わせたスタンドアロンpsレーザーアブレーションの可能性を最大限に引き出すことで、マイクロエレクトロニクスデバイスの高速かつ正確な故障解析がかつてないほど容易になりました。当社の最新論文で、同時連続システム操作で生産性を最大化する方法をご覧ください!

半導体の進歩に伴い、ICパッケージング故障解析ラボは比類のない課題に直面しています。複雑な半導体故障解析の要求、進化するパッケージアーキテクチャ、縮小する機能、エキゾチックで繊細な材料の出現に対処することは、手ごわい仕事です。一方、世界の半導体企業は、洗練された通信機器や多目的な家電製品向けに最先端のチップ、パッケージ、チップレットの開発にしのぎを削っています。
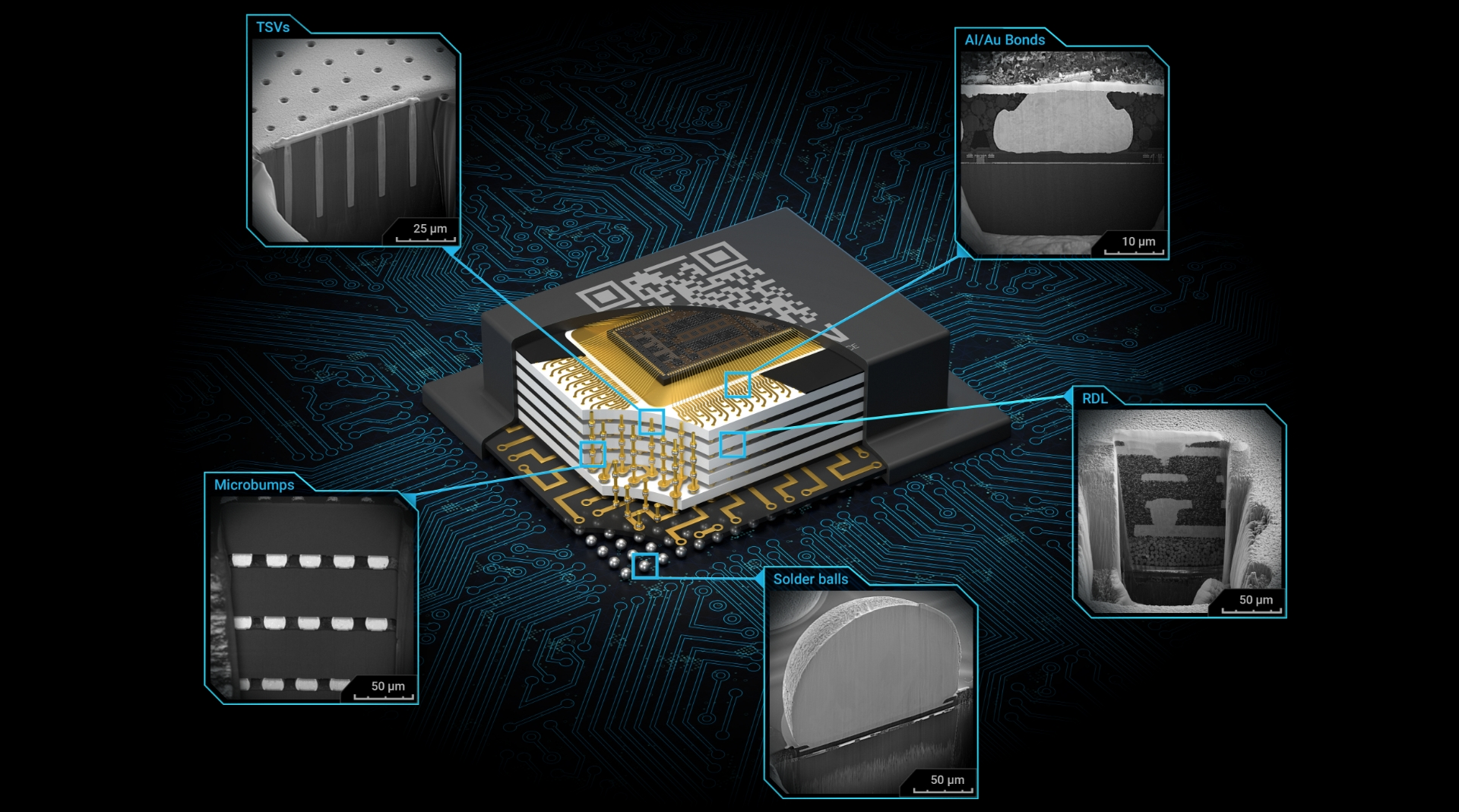
最先端のTESCANソリューションでサステイナブルなICパッケージの故障解析を実現
持続可能なICパッケージの故障解析は、多様な専門知識と、FAツールによって提供される非破壊および破壊手順の広範な範囲にかかっています。TESCANは、非破壊マイクロCT故障解析アプリケーション、プラズマFIB-SEM SOLARIS X、レーザーアブレーションとプラズマFIB-SEM技術をシームレスに組み合わせた大容量ワークフローなどの革新的なソリューションでお客様をサポートしています。
さらに、TESCANは欧州のパートナーと共にFA4.0に取り組んでいます。FA4.0は、マイクロエレクトロニクスにおける故障解析ラボのデジタル化のために、多数の故障解析機器間のより流暢な故障解析ワークフローとデータ管理を確立することを目指すプロジェクトです。FA4.0の詳細については、インサイトセクションをご覧ください!
これらのソリューションが、ICパッケージングの故障解析にどのように新たな力を与えるか、ご自身の目でお確かめください。
最先端のソリューションをご覧ください
TESCAN FIB-SEMを探る
ICパッケージの故障解析におけるディープセクショニングと高分解能エンドポイント測定のための究極のプラズマFIB-SEMプラットフォームを体験してください。
ご質問ですか?
バーチャルデモに興味がありますか?
TESCAN FIB-SEM と半導体および IC パッケージングの故障解析ソリューションに関するご質問には、当社のグローバルチームがお答えします。

