TESCAN 低角度研磨:正確で均一なディレイ加工
包括的
ディレイヤリング
厚い中間層やI/Oデバイス層にわたって徹底したプラズマFIB遅延処理を実行し、従来の方法を超える優れたプロセス制御を確保します。
レイヤースタック
マスター
レイヤスタック全体を正確にナビゲートしたり、単一のプラズマFIBシステムで複合的な手法を利用して、旧来の技術に合わせた遅延処理を行うことができます。
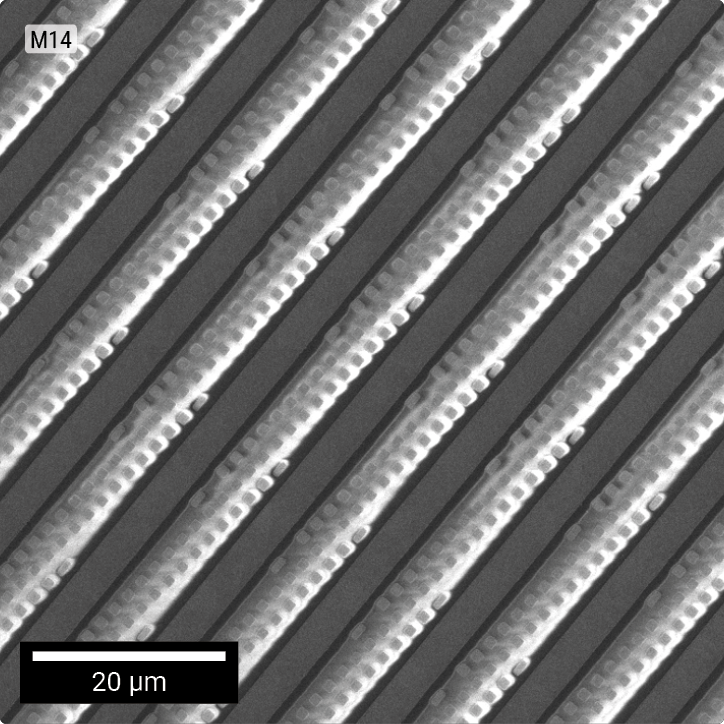

画像は、デバイスのM14およびM13メタル/ビア層を通る均一な遅延を示している。
モニタリング
エクセレンス
連続的なIn-Beam BSE信号評価により、EPD曲線のピークを認識しながら、遅延プロセスを注意深く観察する。
平面性
保証
専用のクランプホルダーを使用することで、従来のマウント技術よりも優れたサンプルの水平性を確保し、最適な遅延平面性を得ることができます。
レシピ
カスタマイズ
お客様のラボの要件に合わせた遅延プロトコルを開発し、サンプルタイプ間の移行を促進する保存された設定を行います。
自信あり
脱プロセス
マルチポジションミリングの定義とモニタリングには、パートナーからの有効なソフトウェアガイダンスを利用し、徹底的で正確な層除去を実現します。
TESCAN低角度研磨による高度な能力
TESCANEssenceTMがもたらす、サンプルのアライメント強化、一貫した遅延、正確なモニタリングの利点をご覧ください。

専用クランプサンプルホルダーにより、サンプルの水平性を確保し、デプロセッシングが可能。
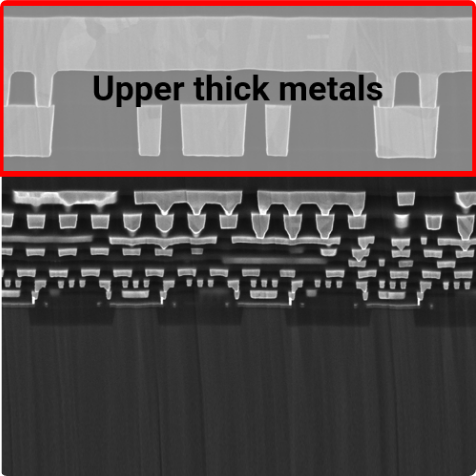
半導体デバイスの厚い中間層や入出力(I/O)領域の均質プラズマFIB遅延処理

TESCANEssenceTMLow Angle Polishingモジュールのライブモニタグラフにプロットされたカラム内BSE信号に基づく強度プロファイルのライブモニタリング。
バーチャル・デモをご希望ですか?
TESCAN FIB-SEM と半導体および IC パッケージングの故障解析ソリューションに関するご質問には、当社のグローバルチームがお答えします。

