レーザーアブレーションとXeプラズマFIB-SEMのペアリング:半導体産業における大規模物理的故障解析における正確な終点測定のためのアプローチ
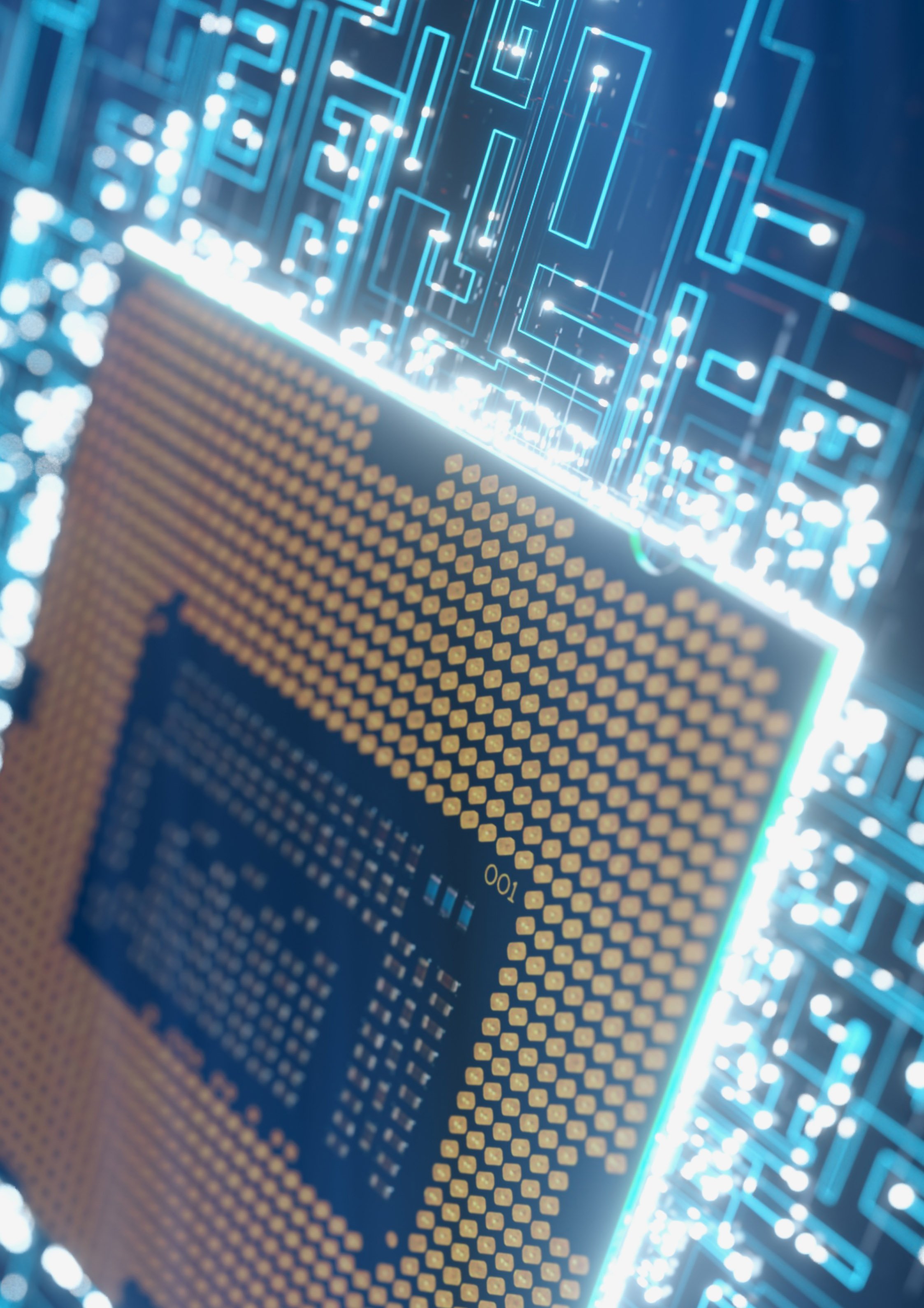
故障解析のためのサンプル前処理にかかる時間とコストを削減したいとお考えですか?
Rodrigo Delgadillo Blando氏らによる "Pairing Laser Ablation and Xe Plasma FIB-SEM: An Approach for Precise End-Pointing in Large-Scale Physical Failure Analysis in the Semiconductor Industry "は、2021年にISTFAで発表された論文であり、psレーザーアブレーションツールとXeプラズマFIB-SEMシステムを用いてマイクロエレクトロニクスデバイスの大容量断面を作成する革新的な方法について述べている。これは、マイクロエレクトロニクスデバイスの故障解析の効率と精度を向上させることを目的とした、非常に関連性の高い最先端の研究である。
著者らは、物理的故障解析(PFA)のためにマイクロエレクトロニクスデバイスの深く埋もれた構造にアクセスすることに伴う課題を取り上げている。機械的研磨やGa+ FIBミリングのような従来の方法は、大容量の試料作製には時間がかかりすぎたり、ダメージが大きすぎたりする。本論文では、psレーザーアブレーションツールの高速な材料除去速度と、XeプラズマFIB-SEMシステムの精密なエンドポインティングと微細な表面研磨能力を組み合わせた方法を提案する。この方法により、マイクロエレクトロニックデバイスの迅速かつ正確なPFAが可能になり、また、両方のツールの同時かつ連続的な操作により生産性が向上することを提案する。
 この研究では、デリケートな材料や複雑な構造で構成されるAMOLEDモバイルディスプレイの損傷や層間剥離のない断面の作成など、さまざまなアプリケーションで提案手法の有効性を実証している。また、高解像度のイメージングと解析を必要とする、はんだボールの材質やサイズが異なるフリップチップパッケージの断面図の作成についても、CADナビゲーション、データ相関、エンドポイント用のビットマップオーバーレイと同様に説明しています。CADナビゲーション、データ相関、エンドポイント用ビットマップオーバーレイ。
この研究では、デリケートな材料や複雑な構造で構成されるAMOLEDモバイルディスプレイの損傷や層間剥離のない断面の作成など、さまざまなアプリケーションで提案手法の有効性を実証している。また、高解像度のイメージングと解析を必要とする、はんだボールの材質やサイズが異なるフリップチップパッケージの断面図の作成についても、CADナビゲーション、データ相関、エンドポイント用のビットマップオーバーレイと同様に説明しています。CADナビゲーション、データ相関、エンドポイント用ビットマップオーバーレイ。
また、CADナビゲーション、データ相関、エンドポイント用のビットマップオーバーレイなど、関連する問題も取り上げている。本論文では、提案手法がアーチファクトや損傷を最小限に抑えた高品質の断面を作成でき、クラック、ボイド、金属間化合物、剥離などの欠陥を明らかにできることを示している。
TESCANソリューションで半導体故障解析を最適化: TESCANソリューションでICパッケージの故障解析をマスターしよう
TESCANソリューションで半導体故障解析を最適化: TESCANソリューションでICパッケージの故障解析をマスターしよう

最新の半導体技術をご覧ください
業界の専門家、研究者、学者の方々と一緒に半導体の未来を探求しませんか。TESCANの専門家チームは、業界の専門家、研究者、学者の方々と交流し、皆様のご要望を伺い、TESCANのソリューションが皆様の研究開発イニシアチブをどのようにサポートできるかを議論できることを楽しみにしています。
